
1、WLCSP是什么?
WLCSP(Wafer Level Chip Scale Package,晶圆级芯片级封装)是一种先进的集成电路封装技术,其特点是直接在晶圆上完成封装,最终封装尺寸接近芯片本身的大小。这种技术通过在晶圆上进行重新布线和凸点制造,实现高密度互联和小型化封装,广泛应用于移动设备、消费电子和高性能计算领域。
2、WLCSP的分类?
扇入型晶圆级芯片封装(Fan - In WLCSP):引脚从芯片四周引出,呈扇形引入到芯片底部,具有尺寸小、成本低、散热性好等特点,但引脚数量较少,无法实现高集成度芯片封装。
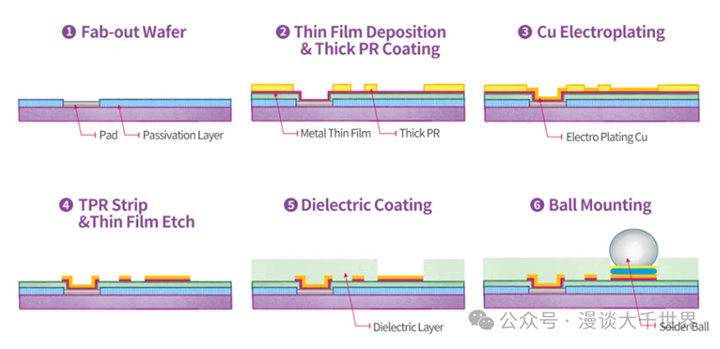
扇出型晶圆级芯片封装(Fan - Out WLCSP):引脚从芯片底部引出,呈扇形引出到芯片外部,引脚数量多,电路设计灵活,能够将多个芯片封装为一体,在满足小尺寸要求的同时可以实现更高集成度。
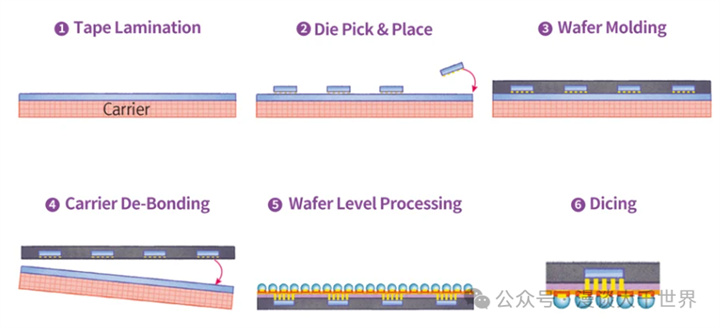
3、WLCSP工艺Flow
1. 晶圆准备
晶圆清洗:去除表面的颗粒、有机物和金属残留。
表面处理:通过化学或物理方法改善晶圆表面的附着性能。
2. 钝化层沉积
在晶圆表面沉积一层钝化材料(如SiO₂或SiN),用于保护内部电路并提供绝缘。常用方法:PECVD(等离子体增强化学气相沉积)。
3. 焊盘开窗
使用光刻技术在钝化层上开窗,露出铝焊盘。通过湿法蚀刻或干法蚀刻实现精确图案化。
4. 重新布线(RDL, Redistribution Layer)
在晶圆表面制作重新布线层,将原本分散的小焊盘重新排列成更大的焊盘阵列。步骤如下,首先沉积导电材料(如铜或铝),其次刻蚀形成所需的布线图案,最后表面钝化处理。
5. 凸点下金属化(UBM, Under Bump Metallization)
在重新布线层的焊盘表面沉积一层或多层金属薄膜,用于提高焊球与焊盘之间的粘附力和导电性。常见材料:Ti/Cu/Ni/Au。
6. 焊球植球
将焊球(如SnAgCu合金焊球)放置在重新布线层的焊盘上。焊球可以通过印刷法、电镀法或回流焊接法固定。
7. 晶圆切割
使用激光切割或划片机将封装好的晶圆分割成单个芯片。注意保持切割路径不会破坏芯片功能。
8. 成品测试
对切割后的单个芯片进行电气性能测试和外观检查。测试内容包括导通性、绝缘性、焊球位置偏差等。
9. 最终封装
将合格的芯片装入最终的包装载体中(如塑料封装体或玻璃基板)。进行密封处理以防止外界环境的影响。




