
1半导体封装技术简介

倒装芯片(Flip chip)技术是通过芯片上的凸点(bump)直接将元器件朝下互连到基板(substrate)、载体或者电路板上。这种封装技术具有较高的信号密度、较小的体积、高速传输和良好的热传导性能,因此在半导体行业得到了广泛应用。

倒装芯片技术起源于IBM,IBM公司在1960年研制开发出在芯片上制作凸点的倒装芯片焊接工艺。后来制作PbSn凸点,使用可控塌焊连接(Controlled collapse Component Connection, 简称C4技术)。C4芯片具有优良的电学、热学性能,封装疲劳寿命至少提高10倍以上。
2倒装芯片的发展历程

伴随半导体芯片体积的逐渐减小,对芯片封装技术要求越来越高,封装技术向着晶圆及封装发展。
在对传统芯片进行封装时,通常是将晶圆进行切割成Die,再对每一个Die进行封装,在新的半导体封装中,将封装工艺与半导体工艺进行融合,在晶圆上对芯片进行统一封装,再切割形成可靠性更高的独立芯片。
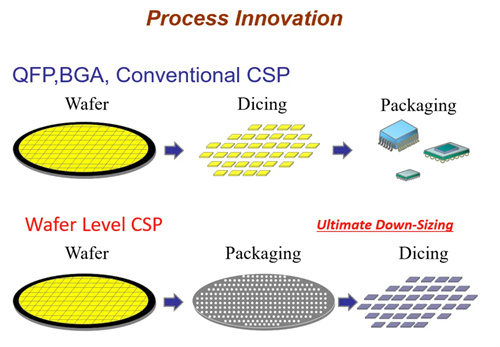
倒装芯片的应用
倒装芯片元件主要用于半导体设备,有些元件,如无源滤波器,探测天线,存储器装备也开始使用倒装芯片技术,由于芯片直接通过凸点直接连接基板和载体上。因此,更确切的说,倒装芯片也叫DCA(Direct Chip Attach),下图中CPU及内存条等电子产品是常见的应用倒装芯片技术的器件。
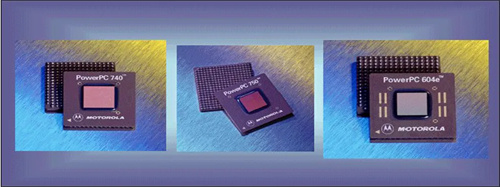
下图是内存条中存储芯片通过倒装技术与线路板连接,芯片与电路板中间通过填充胶固定。
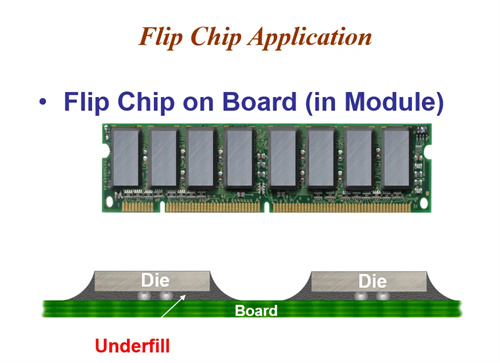
3倒装芯片技术的优点与缺点
倒装连接技术优点:
01小尺寸
小的IC引脚图形 (只有扁平封装的5%)减小了高度和重量。
02功能增强
使用倒装芯片能增加I/O的数量。I/O不像导线键合处于芯片四周而受到数量的限制。面阵列可以在更小的空间里进行更多信号、功率以及电源等互连。一般的倒装芯片焊盘可达400个。
03性能增加
短的互连距离减小了电感、电阻以及电容,保证了信号延迟减少、较好的高频率、以及从晶片背面较好的热通道。
04提高了可靠性
大芯片的环氧填充确保了高可靠性。倒装芯片可减少三分之二的互连引脚数。
05提高了散热能力
倒装芯片没有塑封,芯片背面可进行有效的冷却。
倒装连接技术缺点:
(a)裸芯片很难测试;
(b)凸点芯片适应性有限
(c)随着间距地减小和引脚数的增多导致PCB技术面临挑战;
(d)必须使用X射线检测设备检测不可见的焊点;
(e)和SMT工艺相容性较差;
(f)操作夹持裸晶片比较困难;
(g)要求很高的组装精度;
(h)目前使用底部填充要求一定的固化时间;
(i)有些基板可靠性较低
(j)维修很困难或者不可能。
4关于艾斯达克

艾斯达克始终秉持以客户需求为核心,通过智能装备、精密科技驱动,工业软件打通数据流,数据+AI算法赋能电子及半导体行业智慧仓储,专注产品品质,用心服务的初心。
艾斯达克帮助企业解决智能仓储领域的科学化、标准化、数字化、自动化、智能化升级时遇到的实际问题,提供智慧仓储设备定制化服务。
未来艾斯达克将继续发挥技术、人才和资源方面的优势,为我国制造业的转型升级贡献力量。在这个过程中,艾斯达克将助力更多企业入围灯塔工厂,携手共进,共同推动我国制造业迈向全球价值链顶端。




